基于超薄外延技术的双扩散新型D-RESURF LDMOS设计
2.2 漂移区浓度对击穿电压和导通电阻的影晌
当漏端电位从零开始增加到220V左右时,体内PN节耗尽区随着电压的增加而扩展,直到整个漂移区完全耗尽(此时体内PN节的峰值电场远远小于击穿电场的最小值),电压继续增大过程中,器件表面的P-top、N-结与器件体内的N-、P-sub结的电场峰值在随之上升,在N型漂移区总的注入剂量不变的情况下,HNV注入剂量的增加会使LDMOS表面电场的击穿点的由漏端向P-top的源端方向转移。表现为HNV注入剂量为1.1E 12cm-2~1.35E12cm-2时,N型漂移区浓度偏低,LDMOS的漂移区会在较低的漏源电压下全部耗尽,电场在漏区集中,导致器件首先在漏区/N型漂移区处击穿;N型漂移区表面杂质浓度的增加会使P-top完全耗尽的同时、表面电场的分布更加均匀,导通电阻趋于下降。当HNV注入继续上升时,N型漂移区浓度偏高时,LDMOS的漂移区无法完全耗尽,电场在P-top降场层靠源区一侧集中,器件同样会过早击穿。于此同时DNW的注入浓度在逐步下降,使得整体漂移区比导通电阻会逐渐增加。因此必须折中考虑N型漂移区浓度对器件击穿电压和比导通电阻的影响。
TSUPREM4和MEDICI模拟仿真漂移区浓度分布,当漂移区总注入剂量在2.4E12cm-2~2.7E12cm-2范围内,HNV保持注入剂量在1.1E12cm-2~1.8E12cm-2变化时,器件击穿电压大于700V。考虑到工艺误差等因素,选取漂移区总注入剂量分别为2.5E12cm-2和2.6E12cm-2,HNV注入剂量由1.1E12cm-2~1.8E12cm-2变化时,观察分析击穿电压BV与导通电阻Ron变化情况如图6、7所示。本文引用地址://www.cghlg.com/article/166181.htm
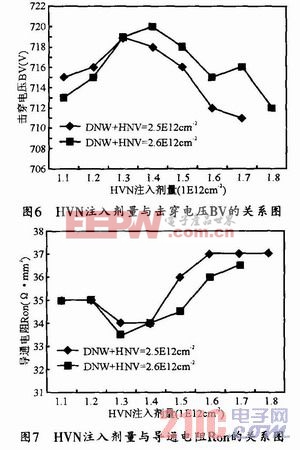
观察HVN注入剂量与击穿电压BV和导通电阻Ron的关系图,当HNV注入剂量由1.1E12cm-2增加时,器件表面浓度得到改善,使击穿电压上升,同时导通电阻也在相应减小,随着浓度的增加,器件漂移区浓度分布趋于最优化。当HNV注入剂量超过1.5E12cm-2继续增加时,漂移区表面浓度过剩,器件此时击穿发生降场层附近。表现为击穿电压逐渐降低,与此同时,漂移区DNW的注入随着HNV的增加而逐渐降低,器件漂移区上下浓度分布失衡,导致器件的导通电阻增大。因此,流片时选取HNV注入剂量为1.3E12cm-2~1.5E12cm-2时,DNW注入剂量为1.1E12 cm-2~1.3E12cm-2。此时对应仿真结果导通电阻小于35Ω·cm2,击穿电压BV大于714V。
3 结束语
本文对一种基于超薄外延技术的双阱LDMOS进行设计研究,该新型器件采用了D-RESURF,横向变掺杂(VLD),双阱注入漂移区等技术。通
过对漂移区表面降场层的几何尺寸和注入浓度的仿真优化,改善了器件表面电场的耐压特性,同时在漂移区总注入剂量不变的情况下,研究了HNV注入浓度与击穿电压与导通电阻的关系,分析研究仿真结果,得出最佳浓度分布。根据这些仿真设计结果,对该型LDMOS进行投片验证,其器件版图如图8所示。当P-top注入剂量为2.5E13cm-3,HNV注入剂量为1.3E12cm-2。DNW注入剂量为1.3E12cm-2时,测试器件结果表明LDMOS击穿电压可以达到690V,结果接近设计要求,实现了与中、低压器件的良好工艺兼容。













评论