基于Arrhenius模型快速评价功率VDMOS可靠性
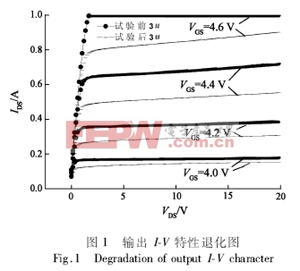
图2为试验中漏源电流IDS退化图(3#、7#、15#为例),其偏置均为VDS=10.1V、VGS=4.8V。可以看出在三组温度应力作用下,漏源电流IDS均出现不同程度的下降,且随着应力的增大,下降幅度增加,温度应力加速器件参数退化,与阿列尼斯方程符合较好。

本试验的失效分布图如图3所示,由图看出本试验在三组温度应力下,样管的失效分布呈三条相互平行的直线,说明在该试验中样管的失效机理是一致的,且由图可知较高的温度应力可以更快地加速参数退化,器件达到失效所需时间更短。此结果与恒定应力加速寿命试验理论相符,说明本试验是一个比较成功的恒定应力加速寿命试验。

3.3 数据分析
本试验样本容量小,故采用精度较高的“最好线性无偏差估计”(BLUE)法进行数据处理。结果如下:①功率VDMOS在室温下(结温117℃)工作时的寿命特征值为3.67×106h;②功率VDMOS的主要失效模式是漏源电流的退化,其失效激活能E=0.54eV;③形状参数m的加权平均值m=1.373;④加速系数τ:τ(240~117℃)≈47.9145,τ(255~117℃)≈67.8953,τ(270~117℃)≈94.3733。
4 结果分析
对三组试验中的失效样管进行结之间(pin-to-pin)电特性测试(第三端开路)。图4、5所示分别为失效样管(以3#为例)与未失效样管(以5#为例)的栅源I-V特性及栅漏I-V特性比较。
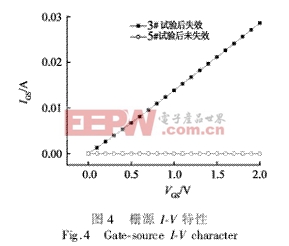
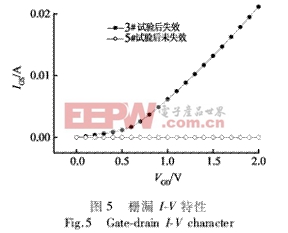
从失效样管的栅源I-V特性及栅漏I-V特性可以判断其栅极出现较大漏电流,说明栅极失去其绝缘能力,发生栅极累积失效。
由VDMOS工作原理可得,栅极发生失效时,其失去绝缘能力,因此当p区反型形成沟道时,部分电子通过已击穿的栅极形成栅极漏电流,使得形成漏源电流的电子减少,造成漏源电流IDS降低。通过上述试验及理论分析可以确定漏源电流的下降是由栅极累积失效而引起的。进一步的栅极失效原因正在研究中,其结果将在后续工作中给予介绍。
5 结论
对功率VDMOS在高温环境下进行恒定应力加速寿命试验得到:
①室温下工作时(结温117℃),其寿命特征值t=3.67×106h,失效激活能E=0.54eV,这些较为完整的可靠性数据为功率VDMOS类型器件在今后的生产和应用中提供参考价值。
②恒定应力加速寿命试验中功率VDMOS的主要失效模式是漏源电流IDS的退化,其失效机理是栅极累积失效。



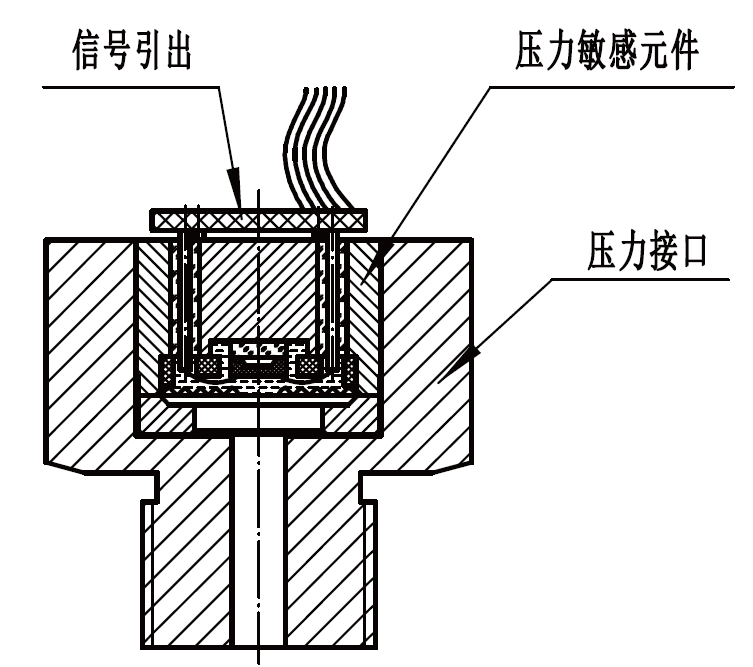
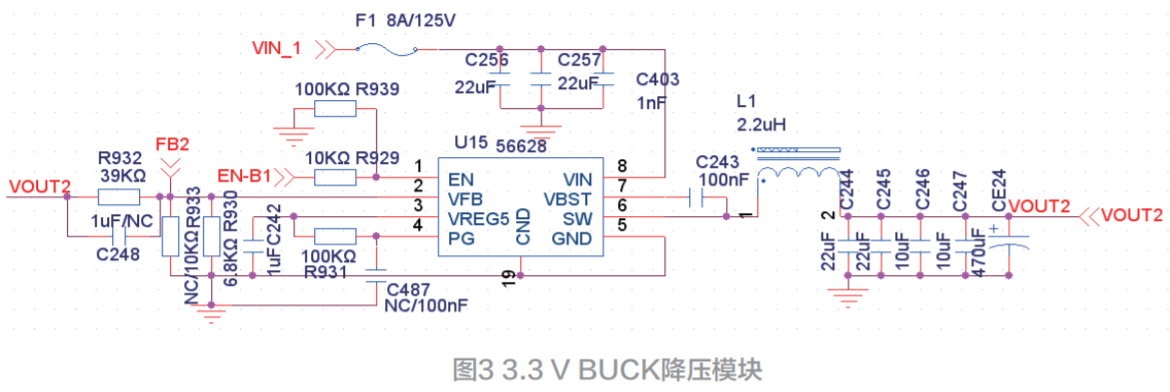



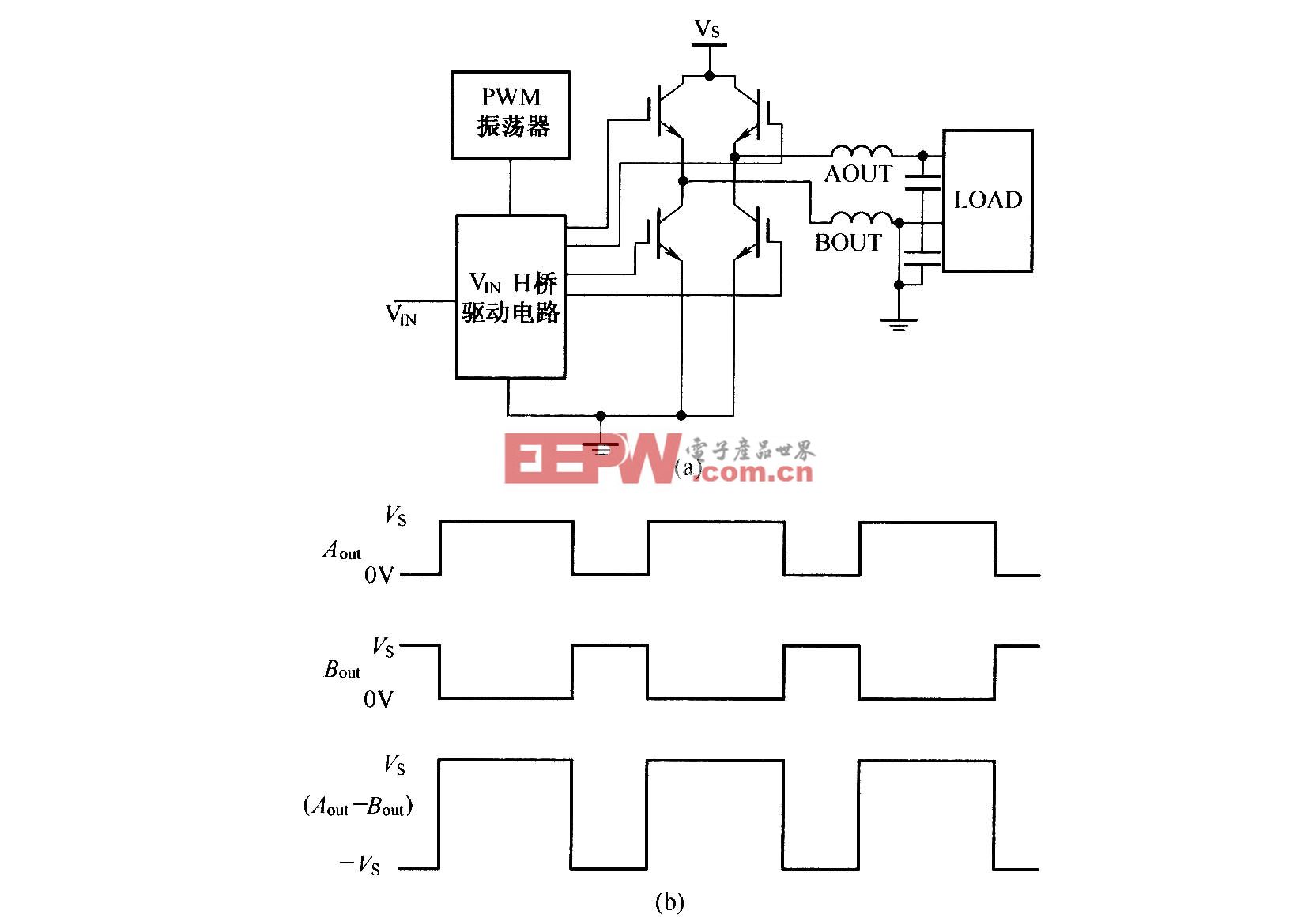





评论